在電子封裝過程中,基板主要起機械支撐保護與電 互連(絕緣)作用。隨著電子封裝技術逐漸向著小型化、高密度、多功能和高可靠性方向發展,電子系統的功率密度隨之增加,散熱問題越來越嚴重。良好的器件散熱依賴于優化的散熱結構設計、封裝材料選擇(熱界面材料與散熱基板)及封裝制造工藝等。其中,基板材料的選用是關鍵環節,直接影響到器件成本、性能與可靠性。
常用的基板材料主要包括塑料基板、金屬基板、陶瓷基板和復合基板四大類。陶瓷基板良好的導熱性、耐熱性、絕緣性、低熱膨脹系數和成本的不斷降低,在電子封裝特別是功率電子器件如IGBT (絕緣柵雙極晶體管)、LD (激光二極管)、大功率LED (發光二極管)、CPV (聚焦型光伏)封裝中的應用越來越廣泛。
電鍍陶瓷基板制備工藝包括采用半導體微加工技術、激光打孔與電鍍填孔技術、電鍍生長控制線并研磨、低溫制備工藝等的優點和缺點及適用需求。金屬線路層與陶瓷基片的結合強度和電鍍填孔是陶瓷基板可靠性的關鍵以及陶瓷基板制備的關鍵技術。
電鍍陶瓷基板的制備及特點
從結構與制作工藝而言,陶瓷基板又可分為HTCC、LTCC、TFC、DBC、DPC等。電鍍陶瓷基板(DPC)是在陶瓷基片上采用薄膜工藝制作完成的,其化學性質穩定、熱導率高、線路精細、熱膨脹系數(CTE)與芯片材料相匹配,因此成為大功率LED封裝散熱基板的重要發展方向。
DPC陶瓷基板制備工藝如圖1所示。首先利用激光在陶瓷基片上制備通孔(孔徑一般為60-120μm),隨后利用超聲波清洗陶瓷基片;采用磁控濺射技術在陶瓷基片表面沉積金屬種子層(Ti/Cu),接著通過光刻、顯影完成線路層制作;采用電鍍填孔和增厚金屬線路層,并通過表面處理提高基板可焊性與抗氧化性,最后去干膜、刻蝕種子層完成基板制備。
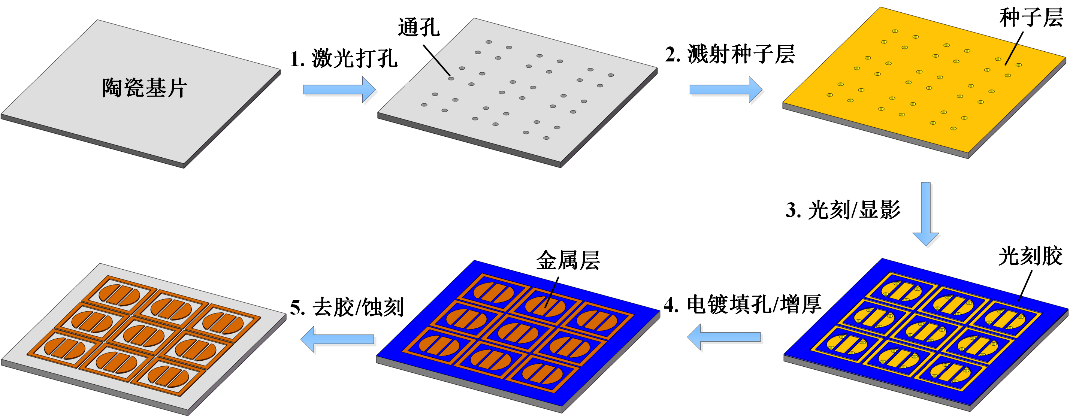
圖1 DPC陶瓷基板制備工藝流程
從上圖可以看出,DPC陶瓷基板制備前端采用了半導體微加工技術(濺射鍍膜、光刻、顯影等),后端采用了印刷線路板(PCB)制備技術(圖形電鍍、填孔、表面研磨、刻蝕、表面處理等),技術優勢明顯。
具體特點包括:1)采用半導體微加工技術,陶瓷基板上金屬線路更加精細,因此DPC基板非常適合對準精度要求較高的微電子器件封裝;2)采用激光打孔與電鍍填孔技術,實現了陶瓷基板上/下表面垂直互聯,可實現電子器件三維封裝與集成,降低器件體積,如圖2所示;3)采用電鍍生長控制線路層厚度(一般為10-100μm),并通過研磨降低線路層表面粗糙度,滿足高溫、大電流器件封裝需求;4)低溫制備工藝(300°C以下),避免了高溫對基片材料和金屬線路層的不利影響,同時也降低了生產成本。
綜上所述,DPC基板具有圖形精度高,可垂直互連等特性,是一種真正的陶瓷電路板。但DPC基板也存在一些不足:1)金屬線路層采用電鍍工藝制備,環境污染嚴重;2)電鍍生長速度低,線路層厚度有限(一般控制在10-100μm),難以滿足大電流功率器件封裝需求。目前DPC陶瓷基板主要應用于大功率LED封裝,生產廠家主要集中在我國臺灣地區,但從2015年開始大陸地區已開始實現量產。

圖2 (a) DPC陶瓷基板產品及其 (b) 截面圖
電鍍陶瓷基板制備的關鍵
金屬線路層與陶瓷基片的結合強度是影響DPC陶瓷基板可靠性的關鍵。由于金屬與陶瓷間熱膨脹系數差較大,為降低界面應力,需要在銅層與陶瓷間增加過渡層,從而提高界面結合強度。由于過渡層與陶瓷間的結合力主要以擴散附著及化學鍵為主,因此常選擇Ti、Cr和Ni等活性較高、擴散性好的金屬作為過渡層(同時作為電鍍種子層)。對陶瓷基片進行等離子清洗可大大提高與金屬薄膜間的結合強度,主要是因為1)離子束去除了陶瓷基片表面的污染物;2)陶瓷基片因受到離子束的轟擊而產生懸掛鍵,與金屬原子結合更緊密。
電鍍填孔也是DPC陶瓷基板制備的關鍵技術。目前DPC基板電鍍填孔大多采用脈沖電源,其技術優勢包括:1)易于填充通孔,降低孔內鍍層缺陷;2)表面鍍層結構致密,厚度均勻;3)可采用較高電流密度進行電鍍,提高沉積效率。由于脈沖電鍍成本高,因此近年來新型直流電鍍又重新得到重視,通過優化電鍍液配方(包括整平劑、抑制劑等),實現盲孔或通孔高效填充。
陶瓷基板應用及分析
01
IGBT 封裝
絕緣柵雙極晶體管以輸入阻抗高、開關速度快、通態電壓低、阻斷電壓高等特點,成為當今功率半導體器件發展主流。其應用小到變頻空調、靜音冰箱、洗衣機、電磁爐、微波爐等家用電器,大到電力機車牽引系統等。由于IGBT輸出功率高,發熱量大,因此對IGBT封裝而言,散熱是關鍵。目前IGBT封裝主要采用DBC陶瓷基板,原因在于DBC具有金屬層厚度大,結合強度高(熱沖擊性好)等特點。
02
LD 封裝
激光二極管(LD)又稱半導體激光器,是一種基于半導體材料受激輻射原理的光電器件,具有體積小、壽命長、易于泵浦和集成等特點。廣泛應用于激光通信、光存儲、光陀螺、激光打印、測距以及雷達等領域。溫度與半導體激光器的輸出功率有較大關系。散熱是LD封裝關鍵。由于LD器件電流密度大,熱流密度高,陶瓷基板成為LD封裝的首選熱沉材料。
03
LED封裝
縱觀LED技術發展,功率密度不斷提高,對散熱的要求也越來越高。由于陶瓷具有的高絕緣、高導熱和耐熱、低膨脹等特性,特別是采用通孔互聯技術,可有效滿足LED倒裝、共晶、COB(板上芯片)、CSP(芯片規模封裝)、WLP (圓片封裝)封裝需求,適合中高功率LED封裝。
04
光伏(PV)模組封裝
光伏發電是根據光生伏特效應原理,利用太陽能電池將太陽光直接轉化為電能。由于聚焦作用導致太陽光密度增加,芯片溫度升高,必須采用陶瓷基板強化散熱。實際應用中,陶瓷基板表面的金屬層通過熱界面材料(TIM)分別與芯片和熱沉連接,熱量通過陶瓷基板快速傳導到金屬熱沉上,有效提高了系統光電轉換效率與可靠性。
參考文獻:
秦典成.陶瓷基板表面金屬化研究現狀與發展趨勢
陳明祥.功率電子封裝用陶瓷基板技術與應用進展
本文來源:搜狐網
標簽: 點擊: 評論:
